

Analysis Lab Service
분석 Lab 서비스
패키지 디캡
패키지 디캡 (Package decapsulation)

IC칩 제조시 칩을 보호하기 위하여 EMC(Epoxy Mold Compound)몰딩, 즉 패키징을 하게 됩니다. 하지만 IC 칩에 대한 분석이 필요할 경우 EMC Mold를 제거해야하는데 이러한 과정을 디캡이라 합니다. EMC Mold 및 Wire 등 전체를 제거하는 Full Decap, 일부만 제거하는 부분 디캡(Partial Decap), 그 외 Multi chip package, MOSFET, IGBT, LED, MEMS, GEL 등의 경우는 기타 디캡(Special Decap)으로 분류하여 목적에 맞는 디캡 서비스를 하고 있습니다. 디캡은 레이저, 케미컬, 메카니컬 등 여러 방법을 사용하여 이루어집니다.
Full Decap
IC만을 회수할 목적으로 IC chip이외의 EMC 및 Package, Wire 등이 모두 제거됩니다.
IC를 회수하여 분석하는데 활용됩니다.
-
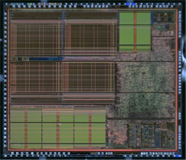 Decap 후 Mark 등 확인
Decap 후 Mark 등 확인
-
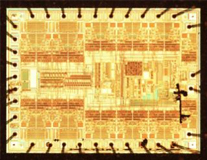 Decap 후 검사(Burnt 확인)
Decap 후 검사(Burnt 확인)
-
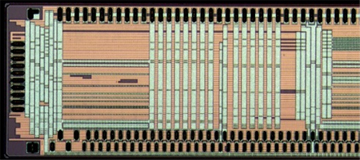 Decap(Film detach)
Decap(Film detach)
Partial Decap
부분 디캡(Partial decap 또는 Hole decap)은 Package의 일부만 제거하여 디캡 후에도 IC의 동작 조건이 유지되기 때문에 FIB 회로수정 또는 EMMI 검사 등
분석이 가능합니다. 또는 Ball bonding, Wire, Lead 등을 분석할 경우에도 활용됩니다.
-
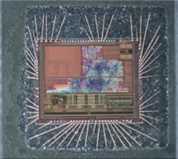 Cu wire 부분 디캡
Cu wire 부분 디캡
-
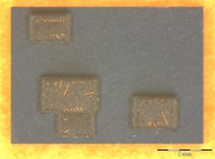 MCP 부분 디캡
MCP 부분 디캡
-
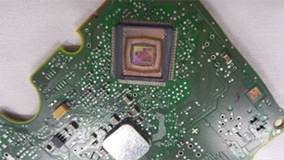 PCB상의 IC Package 부분 디캡
PCB상의 IC Package 부분 디캡
기타 Decap (Special Decap)
일반 패키지가 아닌 모듈타입, 세라믹, Metal CAN, OLED, MEMS, MOSFET 등으로 일반 IC 디캡 과정과 다른 경우의 디캡을 기타 디캡으로 분류 합니다.
-
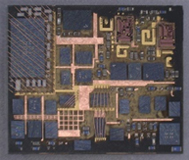 MCP(Multi Chip Package) 디캡
MCP(Multi Chip Package) 디캡
-
 OLED panel 디캡
OLED panel 디캡
-
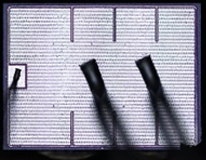 MOSFET 디캡
MOSFET 디캡
-
 MEMS 소자 디캡
MEMS 소자 디캡
-
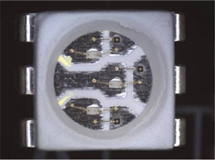 LED 디캡
LED 디캡
-
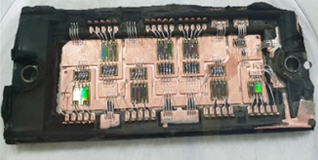 IGBT module 디캡
IGBT module 디캡
-
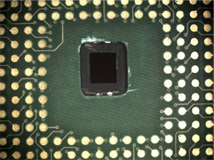 PCB backside 디캡
PCB backside 디캡
-
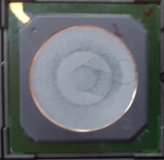 Mechanical 디캡
Mechanical 디캡